碳化硅(SiC)具有優(yōu)良的電學(xué)和熱學(xué)特性,是一種前景廣闊的寬禁帶半導(dǎo)體材料。SiC 材料制成的功率 MOSFET 非常適合應(yīng)用于大功率領(lǐng)域,而高溫柵氧可靠性是大功率 MOSFET 最需要關(guān)注的特性之一。本文通過(guò)正壓高溫柵偏試驗(yàn)和負(fù)壓高溫柵偏試驗(yàn)對(duì)比了自研SiC MOSFET 和國(guó)外同規(guī)格 SiC MOSFET 的高溫柵氧可靠性。負(fù)壓高溫柵偏試驗(yàn)結(jié)果顯示自研 SiC MOSFET 與國(guó)外 SiC MOSFET 的閾值電壓偏移量基本相等,閾值電壓偏移量百分比最大相差在 4.52%左右。正壓高溫柵偏試驗(yàn)的結(jié)果顯示自研 SiC MOSFET 的閾值電壓偏移量較小,與國(guó)外 SiC MOSFET 相比,自研 SiC MOSFET 的閾值電壓偏移量百分比最大相差 11%。自研器件占優(yōu)勢(shì)的原因是在 SiC/SiO2界面處引入了適量的氮元素,鈍化界面缺陷的同時(shí),減少了快界面態(tài)的產(chǎn)生,使總的界面態(tài)密度被降到最低。
引言
SiC 是一種非常優(yōu)秀的半導(dǎo)體材料,擁有優(yōu)良的物理和電學(xué)特性。SiC 材料與 Si 材料相比具有禁帶寬度更寬、臨界擊穿場(chǎng)強(qiáng)更大、電子飽和漂移速度更快等優(yōu)點(diǎn)[1]。與 Si 器件相比,SiC 器件具有更低的導(dǎo)通電阻、更高的開關(guān)頻率,這使得 SiC 器件的導(dǎo)通損耗更小,裝置體積可以做的更小,此外 SiC 器件還具有更好的耐高溫、抗輻射性能[2]。隨著半導(dǎo)體技術(shù)的發(fā)展,Si 基功率半導(dǎo)體器件逐漸逼近其物理極限,在軌道交通、智能汽車、開關(guān)電源、工業(yè)電機(jī)等領(lǐng)域,SiC 功率器件得到快速的發(fā)展和應(yīng)用[3]。在 SiC 功率器件中,SiC 功率 MOSFET 開關(guān)是國(guó)內(nèi)外產(chǎn)業(yè)界和學(xué)術(shù)界研究的重點(diǎn)和熱點(diǎn)[4],國(guó)外的羅姆、科銳、英飛凌等公司都推出了自己的 SiC MOSFET 產(chǎn)品。SiC MOSFET 柵介質(zhì)和溝道界面影響器件的性能與可靠性[5]。本文主要對(duì)自研的 SiC MOSFET 和國(guó)外公司的 SiC MOSFET 器件進(jìn)行高溫可靠性測(cè)試分析。
1 SiC MOSFET 柵氧化層可靠性
SiC基MOSFET器件柵氧界面處的勢(shì)壘高度較低,較低的勢(shì)壘高度使溝道中的載流子更容易穿過(guò)勢(shì)壘來(lái)到氧化層中,影響柵氧化層的質(zhì)量。另一方面,SiC 在氧化過(guò)程中殘留在界面處的 C 元素會(huì)在 SiC/SiO2的界面處帶來(lái)較高的界面態(tài)密度[6]。高密度的界面態(tài)會(huì)影響 SiC MOSFET 器件的性能和可靠性[7]。界面處的電荷陷阱通過(guò)俘獲電荷降低載流子密度,通過(guò)庫(kù)倫散射降低載流子遷移率,影響 SiC MOSFET 的電流能力和跨導(dǎo)等特性;界面態(tài)電荷陷阱在器件開啟和關(guān)斷的過(guò)程中俘獲和釋放載流子,使得 SiC MOSFET 的閾值電壓發(fā)生漂移[8]。柵氧化層和界面態(tài)電荷陷阱增大 SiC MOSFET 在高電場(chǎng)下的隧穿電流,增大漏電流、擊穿柵氧介質(zhì)導(dǎo)致器件失效。
在實(shí)際應(yīng)用中可靠性是評(píng)價(jià)器件性能的重要指標(biāo),因此對(duì) SiC MOSFET 的可靠性進(jìn)行評(píng)估具有重要意義 [1]。以下介紹 SiC MOSFET 的一種可靠性評(píng)估方法,高溫柵偏(High Temperature Gate Bias,HTGB)試驗(yàn)。高溫柵偏試驗(yàn),是模擬 SiC MOSFET 在導(dǎo)通狀態(tài)時(shí)的工作情況,將被測(cè)樣品長(zhǎng)時(shí)間持續(xù)保持在高溫高柵壓應(yīng)力的條件下進(jìn)行考核,然后對(duì)被測(cè)樣品進(jìn)行電學(xué)測(cè)試,監(jiān)測(cè)其漏電流和閾值電壓,并通過(guò)電學(xué)參數(shù)的變化來(lái)評(píng)估被測(cè)器件可靠性的評(píng)估方法[9]。高溫柵偏試驗(yàn)是評(píng)估 SiC MOSFET 器件可靠性的重要試驗(yàn),目的是確認(rèn)有關(guān)晶體缺陷的柵極氧化膜可靠性,對(duì)評(píng)估柵氧化層的穩(wěn)定性具有重要作用。
高溫柵偏試驗(yàn)分為正向高溫柵偏試驗(yàn)和負(fù)向高溫柵偏試驗(yàn)。在正向高溫柵偏試驗(yàn)中,柵極被長(zhǎng)時(shí)間施加直流的正偏壓,SiC 柵氧化層界面中的陷阱俘獲電子使閾值上升。在負(fù)向高溫柵偏試驗(yàn)中,柵極被長(zhǎng)時(shí)間施加直流的負(fù)偏壓,空穴被捕獲,閾值下降。在高溫下施加?xùn)牌珘旱倪^(guò)程中,柵氧化層中的陷阱、可動(dòng)離子,SiC/SiO2界面處的界面態(tài)、近界面態(tài)會(huì)隨著偏壓應(yīng)力的累積發(fā)生俘獲和運(yùn)動(dòng)[8]。高溫下施加在柵極的偏壓應(yīng)力會(huì)向柵氧層中注入并累積一些電荷,電應(yīng)力持續(xù)累積,會(huì)對(duì) SiC MOSFET 的開關(guān)特性造成影響,使得閾值電壓、導(dǎo)通電阻等發(fā)生變化,甚至使器件失效。
2 SiC MOSFET 高溫柵偏試驗(yàn)
2.1 試驗(yàn)原理
高溫柵偏試驗(yàn)通過(guò)同時(shí)施加?xùn)艠O偏置和高溫應(yīng)力來(lái)評(píng)估 MOSFET 器件的柵氧化層可靠性。本次考核試驗(yàn)參考IEC60747-8 標(biāo)準(zhǔn)對(duì)器件進(jìn)行考核。測(cè)試電路圖如圖 1 所示,通過(guò)對(duì) SiC MOSEFT 器件高溫柵偏試驗(yàn)前后閾值電壓 VTH、柵漏電流 IGSS的對(duì)比研究器件在高溫偏壓條件下的可靠性。
2.2 試驗(yàn)過(guò)程
樣品信息:A、B 是自主研制的不同柵氧條件的 SiC MOSFET,R、C 是國(guó)外同規(guī)格器件。挑選 A 器件 5 只、B 器件 5只、R 器件 3 只、C 器件 2 只,共 15 只器件進(jìn)行試驗(yàn)。
試驗(yàn)條件:
1)負(fù)偏壓 HTGB:Tj=175℃,VGS=-5V,VDS=0V,t=168hours,并在試驗(yàn)后 6 小時(shí)、12 小時(shí)、24 小時(shí)、48 小時(shí)、96 小時(shí)、168h 后進(jìn)行器件靜態(tài)特性對(duì)比測(cè)試。
2)正偏壓 HTGB:Tj=175℃,VGS=+20V,VDS=0V,t=168hours,試驗(yàn) 168 小時(shí)后進(jìn)行器件靜態(tài)特性對(duì)比測(cè)試。
通過(guò)對(duì)試驗(yàn)前后閾值電壓 VTH特性及柵漏電特性進(jìn)行對(duì)比,以閾值電壓的漂移幅度作為器件特性變化評(píng)估依據(jù)。
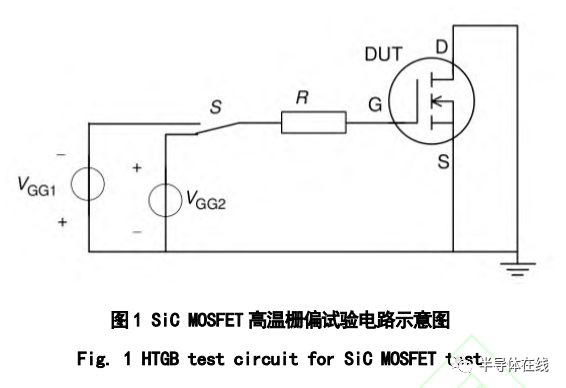
2.3 試驗(yàn)結(jié)果及分析
2.3.1 負(fù)壓 HTGB 試驗(yàn)
圖 2 給出了閾值特性曲線、閾值電壓及閾值電壓漂移情況的實(shí)驗(yàn)結(jié)果。

不同器件的閾值電壓變化情況如表 1 所示

從圖 2 以及表 1 可以看出,對(duì)于四種不同的 SiC MOSFET:
1)168 小時(shí)考核前后,自研器件 A、B 的閾值電壓偏移量分別是 0.2V、0.16V,國(guó)外器件 R、C 的閾值電壓偏移量分別是 0.21V、0.15V,A 與 R、B 與 C 分別相差 0.1V;自研器件 A、B 閾值電壓偏移量百分比的變化分別是 10.29%、7.41%,國(guó)外器件 R、C 閾值電壓偏移量百分比的變化分別是 5.77%、6.37%。自研器件與國(guó)外器件相比,差距不大;自研器件 A與 B 相比,器件 B 閾值電壓偏移量更小。
2)隨著考核時(shí)間的增加,閾值電壓逐漸減小,減小的幅度越來(lái)越小。
圖 3 給出了反向高溫柵偏試驗(yàn)前后正向柵源漏電流(IGSSF)和反向柵源漏電流(IGSSR)的實(shí)驗(yàn)結(jié)果。
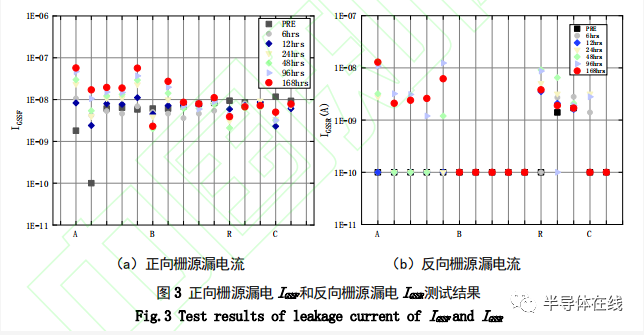
從圖 3 可以看出對(duì)于四種不同的 SiC MOSFET 器件:
1)正向柵源漏電流有隨偏壓時(shí)間的增加而增加的趨勢(shì),試驗(yàn)都在 10nA 左右,自研器件和國(guó)外同規(guī)格器件之間沒有明顯區(qū)別;自研器件 A 與 B 相比,正向柵漏電流沒有明顯區(qū)別。
2)R 組中有一個(gè)器件在試驗(yàn)前的反向柵源漏電為 2nA,其它器件的反向柵源漏電在試驗(yàn)前都低于 0.1nA,試驗(yàn)后 B組器件仍低于 0.1nA,其他 3 款器件增加到 5nA 左右。在負(fù)壓柵偏試驗(yàn)中,自研器件反向柵漏電流變化幅度更小,穩(wěn)定性更好;自研器件 A 與 B 相比,器件 B 的反向柵漏電流更小。
2.3.2 正壓 HTGB 試驗(yàn)
圖 4 給出了正向高溫柵偏試驗(yàn)后閾值特性曲線、閾值電壓、閾值電壓偏移量的結(jié)果。

正壓高溫偏壓試驗(yàn)前后不同器件的閾值電壓變化情況如表 2 所示:

圖 4 以及表 2 可以看出,對(duì)于四種不同的 SiC MOSFET,正向高溫柵偏試驗(yàn)前后:
1)自研器件 A、B 的閾值電壓偏移量較小,分別是 2.18V、2.40V,偏移量大約為 18%;國(guó)外同規(guī)格器件 R、C 的閾值電壓偏移量較大,分別是 3.98V、2.58V,偏移量在 29%左右。這說(shuō)明自研器件在正向高溫柵偏試驗(yàn)中的可靠性要優(yōu)于國(guó)外同規(guī)格的器件。
2)自研器件 A、B 在試驗(yàn) 24 小時(shí)之后復(fù)測(cè),閾值電壓回復(fù)量在 0.2V 左右;國(guó)外同規(guī)格器件閾值電壓的回復(fù)量在0.6V 左右,表明自研器件具有更優(yōu)的閾值穩(wěn)定性高溫柵偏試驗(yàn)前后的正向柵源漏電流(IGSSF)和反向柵源漏電流(IGSSR)如圖 5 所示。
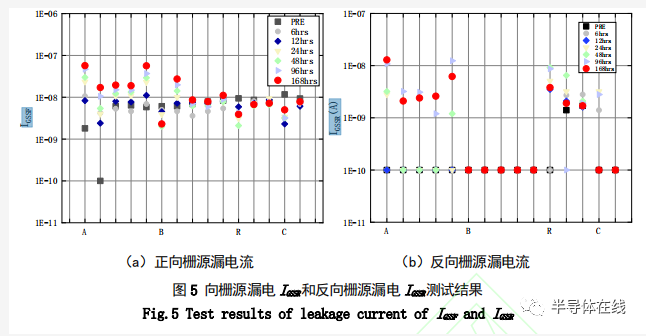
從圖 5 可以看出,對(duì)于 4 種不同的 SiC MOSFET 器件,經(jīng)過(guò)正向 HTGB 試驗(yàn):
1)正向柵源漏電流經(jīng)過(guò)正向高溫柵偏試驗(yàn)都有變小趨勢(shì),四款器件沒有明顯區(qū)別,說(shuō)明自研器件與國(guó)外同規(guī)格器件性能相近。
2)反向柵源漏電流在試驗(yàn)前后都比較小。器件 A、B、R 的反向柵漏電流在試驗(yàn)前后和 24 小時(shí)之后復(fù)測(cè)都低于 1nA;C 組器件中,第一個(gè)器件的反向柵源漏電在試驗(yàn)前后分別是 1.5nA 和 nA,24 小時(shí)之后復(fù)測(cè)為 4nA,第二個(gè)器件的反向柵源漏電在試驗(yàn)前后都小于 1nA,24 小時(shí)之后復(fù)測(cè)為 1.6nA。
對(duì)兩款自研器件的柵氧工藝條件進(jìn)行分析,如表 3 所示。

樣品 A 與樣品 B 相比,改變了氮化氣體的體積分?jǐn)?shù),氮化氣體的體積分?jǐn)?shù)分別為 6%和 12%。SiC 進(jìn)行氮化退火的機(jī)理是引入氮元素,與表面的 C 相關(guān)缺陷結(jié)合,鈍化界面態(tài)從而降低表面的界面態(tài)。但是,有文獻(xiàn)指出,引入的氮原子數(shù)量過(guò)多時(shí)引入的 N 原子與 C 相關(guān)缺陷等結(jié)合后在界面處形成空穴陷阱,使界面態(tài)密度不能降到最低[10-11]。其中東京大學(xué)和范德比爾特大學(xué)都有相關(guān)研究,東京大學(xué)指出界面處的 N 含量與快界面態(tài)的密度呈正比,美國(guó)范德比爾特大學(xué)的 Rozen 等人證明了在對(duì) SiC/SiO2和 Si/SiO2界面系統(tǒng)進(jìn)行氮化退火處理時(shí),退火后的半導(dǎo)體/SiO2界面及近界面的空穴陷阱密度和 N 的含量成線性關(guān)系,N 的含量越多,空穴陷阱密度越大。
在負(fù)偏壓柵漏電測(cè)試實(shí)驗(yàn)中,測(cè)試溫度為室溫,P-F 隧穿電流與溫度呈指數(shù)關(guān)系,且隨溫度的增加而增加。結(jié)合Le-Huu 等人對(duì) SiC MOS 柵漏電流的研究成果,可以認(rèn)為我們測(cè)試得到的漏電結(jié)果,以 P-F 隧穿電流為主,F(xiàn)-N 隧穿電流占柵漏電流較小的部分。在柵漏電流的測(cè)試結(jié)果中,的柵漏電流正向柵漏電流差距不大,反向柵漏電流樣品 B 的最小。根據(jù) P-F 隧穿電流的隧穿機(jī)理,在第一階段空穴通過(guò)隧穿過(guò)程進(jìn)入到 SiO2中的陷阱能級(jí),然后在第二個(gè)階段通過(guò)熱激發(fā)轉(zhuǎn)移到氧化層中,陷阱能級(jí)在其中起重要作用。結(jié)合上文中提到的退火條件對(duì)界面密度的影響,可以分析得出,樣品 B 的退火條件向界面引入了合適的 N 原子,在鈍化界面缺陷的同時(shí),生成的界面空穴陷阱較少,使界面處的缺陷總量較小,較小的界面缺陷使得樣品 B 在高溫偏壓試驗(yàn)前后的閾值電壓漂移量較小,反向偏壓漏電也較小,反向偏壓漏電和高溫偏壓漏電的結(jié)果可以相互驗(yàn)證。
3 結(jié)論
本文對(duì)自研器件和國(guó)外同規(guī)格器件進(jìn)行正壓和負(fù)壓高溫柵偏試驗(yàn),通過(guò)觀測(cè)試驗(yàn)前后的閾值電壓、正向柵源漏電流和反向柵源漏電流的變化量對(duì)器件的可靠性進(jìn)行分析。
在負(fù)壓高溫柵偏試驗(yàn)中,自研器件與國(guó)外器件的閾值電壓變化量絕對(duì)值相差不大,分別是 0.2V、0.16V 與 0.21V、0.15V,自研器件的閾值電壓偏移量百分比與國(guó)外器件相比稍大;自研器件和國(guó)外器件的柵源漏電流沒有明顯差別。
在正壓高溫柵偏試驗(yàn)中,自研器件與國(guó)外器件閾值電壓漂移分別是 2.18V、2.40V 和 3.98V、2.58V;自研器件與國(guó)外器件的正向柵漏電流變化相當(dāng),反向柵漏電流與國(guó)外器件相比更穩(wěn)定。
自研器件 A 和 B 的氮化氣體體積分?jǐn)?shù)分別是 12%和 4%,器件 A 在 SiC/SiO2界面處引入了過(guò)量的氮元素,鈍化界面缺陷的同時(shí),快界面態(tài)的產(chǎn)生過(guò)多,界面態(tài)密度沒有被降到最低;器件 B 在 SiC/SiO2界面處引入的氮元素含量適當(dāng),鈍化界面缺陷的同時(shí),減少了快界面態(tài)的產(chǎn)生,使總的界面態(tài)密度被降到最低。
來(lái)源:電源學(xué)報(bào) 作者:中國(guó)科學(xué)院大學(xué)微電子學(xué)院 劉建君,中國(guó)科學(xué)院微電子研究所 陳宏 、白云、郝繼龍、韓忠霖,株洲中車時(shí)代半導(dǎo)體有限公司 丁杰欽
(以上文章系轉(zhuǎn)載,并不代表半導(dǎo)體在線的觀點(diǎn),如有涉及版權(quán)等問(wèn)題,請(qǐng)聯(lián)系我們以便處理)
